

垂直集成多根纳米线场效应晶体管
在过去的几十年里,晶体管在信息技术进步中起到关键作用。与此同时,金属-氧化物-半导体场效应晶体管几何尺寸的小型化一直是硅基半导体技术的研究核心。然而,晶体管特征尺寸持续的降低必然导致致命的短沟道效应。为了克服短沟道效应,微电子工业界提出多种由三维结构替代传统的二维结构的场效应晶体管构造。韩国高等科学技术研究所的B.H. Lee等人开发了一种名为同工序全干法刻蚀工艺,制备了垂直方向上堆栈式多跟纳米线三维场效应晶体管。这一工艺中,首先制备氧化物硬掩模图形,然后采用高分子C4F8对其进行钝化处理,然后通过SF6气氛下形成的等离子体各向同性刻蚀,获得最上方的纳米线,如图a的第一个循环所示;然后再次进行C4F8钝化处理与干法刻蚀,形成第二层的纳米线,重复多次,可有获得垂直多根纳米线结构。然后通过一系列的平面器件加工工艺,如平坦化、介质沉积以及通孔加工工艺,制备场效应晶体管器件。
这种垂直集成的多根纳米线三维晶体管的电学特性测试表明,这一结构能较大地抑制短沟道效应。该工艺具有与互补金属氧化物半导体工艺兼容,对高集成三维非易挥发性存储器的发展具有重要意义。该项工作发表在Nano Lett. 15(2015) 8056-8061上。
相关链接:http://pubs.acs.org/doi/pdf/10.1021/acs.nanolett.5b03460
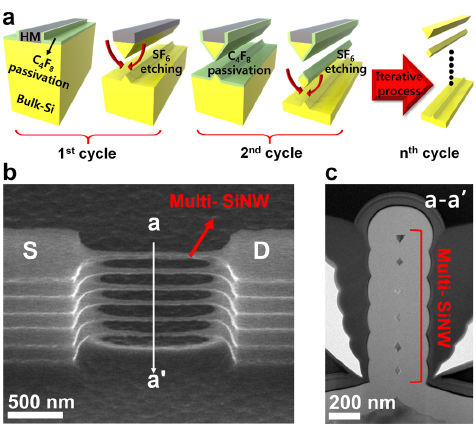
图1:垂直多根纳米线结构与器件: 全干法刻蚀工艺(ORADEP)示意图 (上);垂直集成多根纳米线场效应晶体管结构图及其横截面。

图2:垂直多根纳米线结构的TEM横截图及其高分辨、化学组份与电子衍射图。

图3:垂直多根纳米线结构场效应晶体管电学特性。
